
분석 Lab 서비스
분석서비스
시편준비
IC 패키지, Automotive 용 module, PCB, Ceramic, Metal CAN 등 다양한 시료에 대하여 시료 준비가 가능 합니다.
- Milling machine : EMC package, PCB, Mold, Metallic module, etc
- Automatic Diamond Saw : EMC package, Package module, Mold, Metallic module, Set, etc
- Surface Grinding
- Wafer cleaving : Si wafer
- Pt coating
- Chemical etching
- Plasma etching
케미컬 처리
시편 분석 시 필요한 다양한 케미컬 전처리가 가능합니다.
- Solder ball etch
- Passivation crack test
- Underfill 수지 제거
- Si gel 제거
- Potting 제거
- Automotive용 수지제거
- Si etch
- Oxide etch
- Junction stain
-
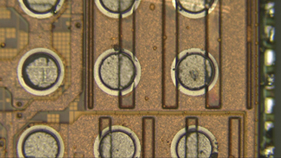 Solder ball etch
Solder ball etch
-
 Passivation crack test
Passivation crack test
-
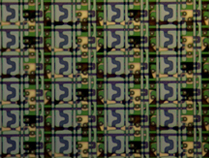 OLED 수지 제거 후
OLED 수지 제거 후
-
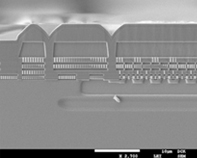 Junction Stain
Junction Stain
-
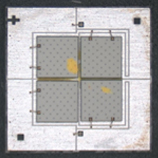 수지제거 후
수지제거 후
-
 MEMS 센서
MEMS 센서
-
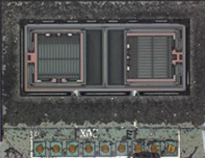 MEMS 센서
MEMS 센서
-
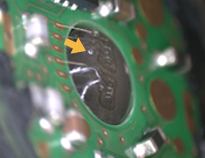 Gel 제거 전
Gel 제거 전
-
 Gel 제거 후
Gel 제거 후
-
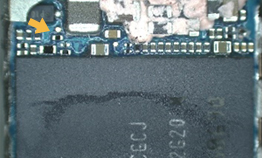 수지제거 전
수지제거 전
-
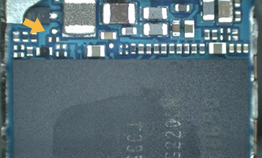 수지제거 후
수지제거 후
De-Layering 분석
IC chip 제조 공정의 역순으로 Layer를 하나씩 Strip 하는 분석 방법입니다. 불량분석 및 벤치마크시 활용됩니다.
-
 Top metal
Top metal
-
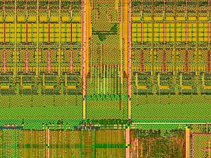 M4
M4
-
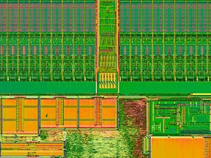 M3
M3
-
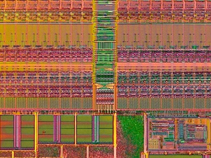 M2
M2
-
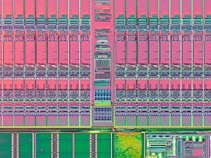 M1
M1
-
 Poly Layer
Poly Layer
Examples
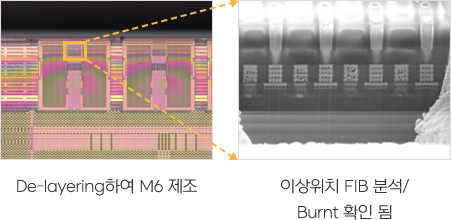
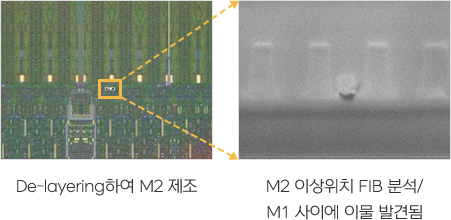
Broad Ion Beam 단면분석
Size가 수백um 크기로 큰 경우 사용하는 단면 분석 방법으로 Ion beam을 사용하기 때문에 품질이 매우 우수합니다.
- 최대 시료 크기: 10mm(W) x 10mm(L) x 1mm(T)
- Cross section width : 약 300 ㎛
-
 Ball bonding
Ball bonding
-
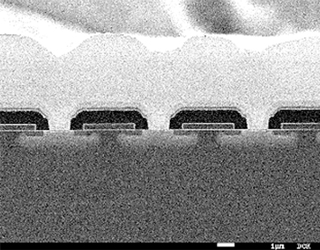 MOSFET
MOSFET
-
 LED
LED
Molding/Polishing 분석
작은 시료를 진공상태에서 Epoxy molding을 한 후 절단하고 연마 합니다. 관찰영역이 단면 시료 전체로 넓게 볼 수 있다는 장점이 있습니다.
-
 진공몰딩
진공몰딩
-
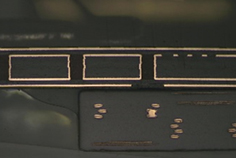 PCB 단면분석
PCB 단면분석
-
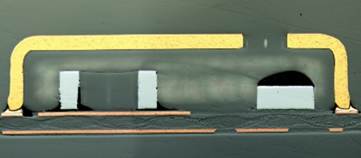 압력센서 단면분석
압력센서 단면분석
-
 MLCC 단면 분석
MLCC 단면 분석
-
 IC 단면분석
IC 단면분석
IC Backside 분석
Top에서 분석이 불가한 경우 Si 기판을 제거하고 분석 할 수 있는 방법입니다.
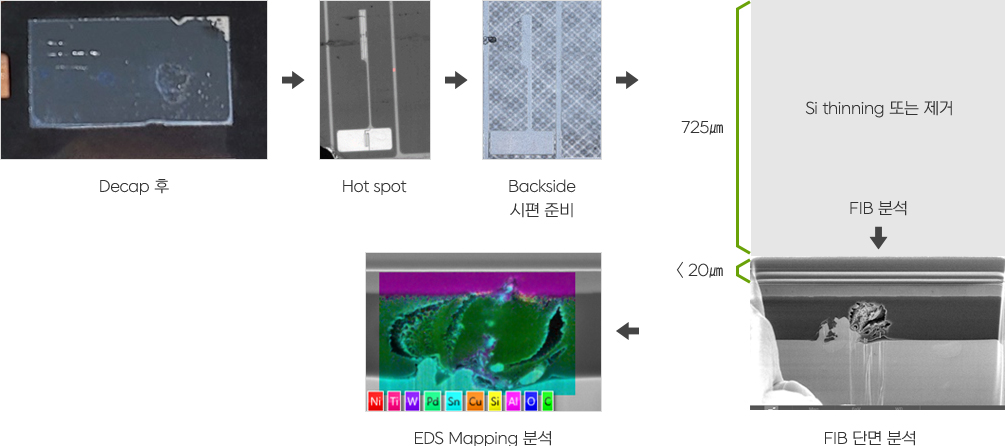
PCB 분석
PCB de-layer 후 사진촬영(합성)하여 드립니다.
PCB de-layering
BM(Bench Mark) 분석
BM 분석은 Package 및 decap후 IC 에 대하여 분석이 진행됩니다.
FIB, De-layer등 필요한 작업을 통하여 IC에서 필요한 정보가 확보됩니다.
-
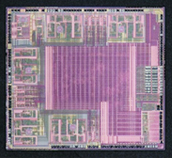 Decap
Decap
-
 Mark 확인
Mark 확인
-
 단면분석
단면분석
-
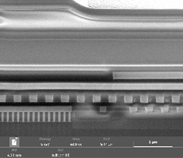 단면분석
단면분석
-
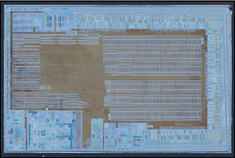 Active layer 분석
Active layer 분석

Active layer 분석
상부의 Passivation Layer etch 및 Metal layer를 전부 제거합니다.
Active Layer(Substrate) 상태에서 불량분석 및 정보를 획득 합니다.
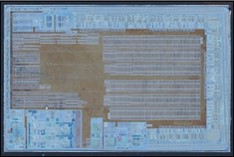 Active layer
Active layer